JFE-TEC News
KTEC News
No.31 400kV分析電子顕微鏡によるシリコンウェーハ中析出物の極微電子回析
“KTEC News”は、旧・川鉄テクノリサーチ(株)が年4回発行していた小冊子です。バックナンバーとして掲載しておりますが、現在お取り扱いしていない製品・サービスの場合もございますので、ご了承ください。
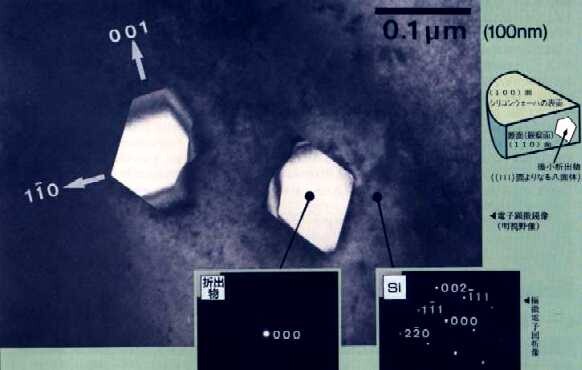
分析電子顕微鏡(AEM:Analytical Electron Microscope)では、元素分析のほかに、5nm(百万分の5nm)程度の極微小部における電子回析像を得ることで、その部分の結晶構造とともに周囲の地(マトリックス)との方位関係について知ることが可能である。
上の写真は、シリコンウェーハ((100)面)を1100℃以上で20時間過熱した際に生成する酸化物系の八面体析出物極微電子回析例を示す。電子顕微鏡像および回析像は模式図のような(110)面に平行な断面の薄膜試料について得られている。析出物はSiの(111)面で囲まれた八面体構造特有の形状であり、析出物の立体構造に対応する等厚干渉縞が現れている。写真中に示されている黒丸の位置で、析出物内および周辺のマトリックスそれぞれ一点で極微電子回析像が得られており、電子顕微鏡像の下方に示されている。
マトリックスの回析から、析出物の縦方向がSiマトリックスの〈001〉軸と一致し、直角方向の軸が〈110〉軸と一致する矢印の方位関係が見られる。また、析出物の中身に相当する電子回析像は、マトリックスとは全く異なり結晶構造を持たないもの“非晶質”に対応している。
この結晶Siに析出するSiOXの非晶質析出物は、数十mm 程度の巨視的な試料についての赤外線吸収スペクトルよりその存在は早くから知られていたが、極微回析による直接の解析例はなかった。このような極微回析を含むAEMによる極微小部の構造解析技術は今後も重要性を増すと思われる。
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業本部
- 0120-643-777


