JFE-TEC News
KTEC News
No.49 基盤配線の非破壊観察
“KTEC News”は、旧・川鉄テクノリサーチ(株)が年4回発行していた小冊子です。バックナンバーとして掲載しておりますが、現在お取り扱いしていない製品・サービスの場合もございますので、ご了承ください。
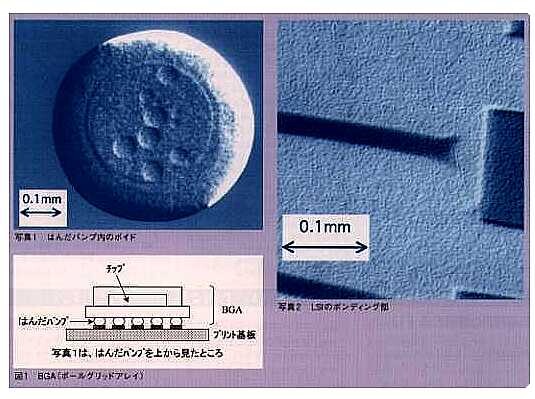
写真1は、プリント基板上に実装されたBGAタイプのLSIチップ(図1)のはんだバンプ内のボイドを、マイクロフォーカス透過X線顕微鏡装置によって観察した例です。0.5mmのはんだバンプの中の10μm程度のボイドを観察することができます。
写真2は、パッケージされたままのLSIのボンディングワイヤを観察した例です。ワイヤが切れてリードフレームから外れているのが分かります。
近年、部品がますます小型化され、プリント基板にも多数の部品が実装されるようになっています。そのため、部品を分解して光学的に観察するという従来の手法では不良箇所の観察が難しくなっています。最近では、部品のプリント基板へのはんだ付け方法も、BGAなどはんだボールを使用したものが登場し、はんだ付けされた部分が表面から全く見えない場合も増えてきています。また、高価なプリント基板の場合は破裂して検査することができないなど、非破壊検査の必要性はますます高まっています。
マイクロフォーカス透過X線顕微鏡を利用すると、基板に部品を載せたままで非破壊検査が可能であり、観察できる試料のサイズは350mm×300mmとかなり大型のプリント基板もそのまま観察できます。さらに、事前の準備なしですぐに観察できるのもこの装置の特徴であり、画面を見ながら不良箇所を探していくという場合にも非常に有効です。
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業本部
- 0120-643-777


