ニュース
2021年01月15日
数十ミクロン領域における熱ひずみ分布解析技術を確立
JFEテクノリサーチは、走査電子顕微鏡(SEM:Scanning Electron Microscope)を用いたデジタル画像相関法(DIC:Digital Image Correlation)によるミクロンレベルの微小領域におけるひずみ分布を可視化し、かつ500℃までの熱膨張収縮にともなうひずみ変化を捉える技術を開発しました。この技術により自動車の電動化開発のために必要な高温環境下での信頼性確保が必要な電子部品・機器の開発に貢献します。
近年、自動車の電動化・電子化にともない、バッテリーからモーターなどに供給される電力を制御するため、車載用パワーデバイスが多用されています。OnとOffを繰り返して、大電流を制御するため、一般にパワーデバイスは発熱します。デバイスの小型化向けの開発により、200℃を超える高温で動作するようになっています。多種の材料(半導体素子、金属製電極、フレーム、はんだなどの接合材料、モールド樹脂など)で構成されるパワーデバイスは、On/Offに伴って生じる急速な発熱/冷却により、異種材料界面で、特に、熱膨張率が大きく異なる樹脂と金属・半導体との界面でひずみが発生します。長期間の繰り返しされると、界面で破壊が生じ、デバイス信頼性を低下させます。このような界面破壊を抑制し長寿命パワーデバイス開発のために有用な情報を与える、温度変化にともなうデバイス内のひずみ分布を評価することが強く求められています。
従来から、光学顕微鏡観察にDIC法を適応して、動的(例えば引っ張ったり、圧縮したりしながら)な材料のひずみ分布が計測されています。弊社でも、薄鋼板の引張変形などの解析用に合わせ、DIC技術を開発をしてきました。しかし、高倍観察が難しい光学顕微鏡(典型的な計測サイズ:十数μm前後(1μmは0.001mm))を用いる限り、パワーデバイス層間に発生するわずかなひずみの計測はできなません。このDIC法を高倍観察可能なSEM観察に適応できると、パワーデバイスの半導体・金属電極と樹脂界面のひずみ(計測サイズ:1μm以下程度)評価が可能になります。このニーズに合わせ、ひずみ解析に必要な幾何学的なランダム模様をSEM観察に適正化し、かつ温度変化にも影響がない効果的なランダム模様を短時間で形成する技術を確立し、観察試料温度を500℃まで変化させながら形状を精度よく測定できるSEMを用いることで、新しいSEM観察によるDIC技術を開発しました。その結果、パワーデバイスの半導体・金属電極と樹脂界面において、200℃程度の高温で発生するひずみの可視化を実現しました。
当社では、千葉、川崎に拠点を置くナノ解析センターにて、この技術による受託解析を2020年9月から開始しました。今後も自動車の電動化に向けた開発に対して、各種材料に対するナノレベルの構造解析からモーターや電池などを含む主要部品の評価・試験など、受託調査により社会に貢献します。
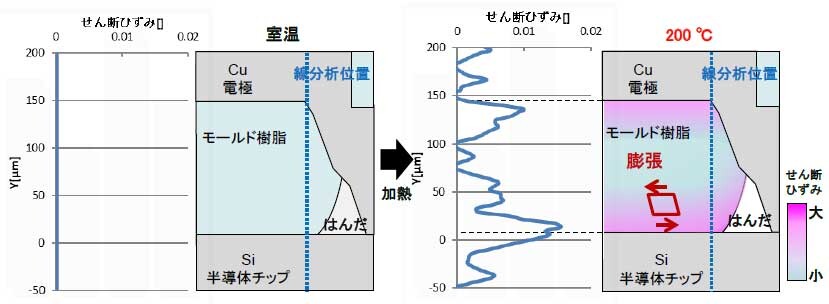
パワーデバイスのモールド樹脂部におけるXYせん断ひずみ分布の計測結果(左:せん断ひずみ線分析、右:マッピングイメージ)
関連リンク・関連記事
- パワーデバイス樹脂/半導体異材界面の熱ひずみ分布解析 [事例集PDF]
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業本部
- 0120-643-777


