JFE-TEC News
No.13「電子で量る(4)」
JFE-TEC News No.13号 面ひずみのパターン測定 他 記事一覧
電子で量る(4)
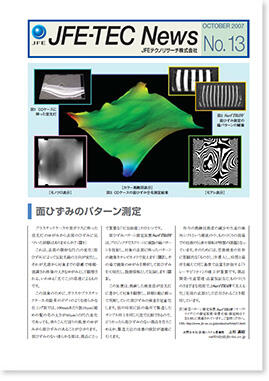
全文 PDF (458.6 KB)
No.13 面ひずみのパターン測定 他
電子で量る(4)~薄膜表面の分析技術としてのAESおよびXPS~
1keV程度以下の低エネルギー電子の平均自由行程(電子がエネルギーを失わないで移動できる距離)がnmレベルと小さいので、試料から放出される低エネルギー電子を検出すると、極表面の分析ができます。今回は、このような表面分析手法であるオージェ電子分光分析法(AES: Auger Electron Spectroscopy)とX線光電子分光分析法(XPS: X-ray Photoelectron Spectroscopy)を紹介します。
オージェ電子分光分析法:AES
AESは、試料に電子を照射した時に放出されるオージェ電子を検出する表面分析法です。AESでは、試料極表面(数nm)に存在する元素の定性および定量分析が可能です。試料をイオンエッチングしながら測定すると、深さ方向の元素分布の分析が可能です。照射する電子線を細く絞ることで数10nmの微小部を分析でき、かつ電子線を走査すると二次元の元素分布を得ることができる、などの特徴があります。
X線光電子分光分析法:XPS
XPSは、X線を照射し光電子を測定する分析法です。XPSでは、AESと同じく試料表面 数nmの定性・定量分析と、深さ方向分析も可能です。加えて、光電子の化学シフト(化学状態による元素の運動エネルギー変化)から、元素の化学結合状態が推定できます。最近導入した装置では、10μm程度の二次元分布も得ることができるようになりました。
AES深さ方向分析の例
図に、GaAs基板上のGaAs/AlAs超格子薄膜(計4層、それぞれの膜厚: 25nm)を、Arイオンスパッタリングしながら、AESで深さ方向分析を行った例を示します。薄いGaAs層とAlAs層とが、深さ方向に交互に分布することが明確になっています。このように、AESやXPSを用いて、nmからμm程度の深さの分析が可能です。多層化・極薄化の進んでいる薄膜材料、表面処理材料など、ナノレベルの薄膜構造・表面構造を明らかにしています。
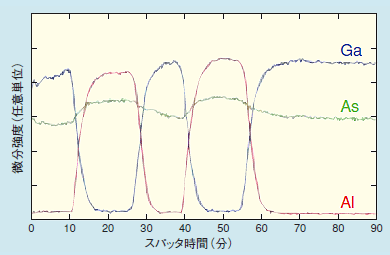
(スパッタ時間0分は表面での組成を示し、
この時間が大きいところは深さ方向での、内部組成を示す。)
図 GaAs/AlAs超格子薄膜のAES深さ方向分析結果
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


