JFE-TEC News
No.52「【最新技術紹介】新しい透過電子顕微鏡技術(1)」
JFE-TEC News No.52号 小特集:カーエレクトロニクスVol.2 記事一覧
【最新技術紹介】新しい透過電子顕微鏡技術(1)

全文 PDF (1.7 MB)
No.52 小特集:カーエレクトロニクスVol.2
【最新技術紹介】新しい透過電子顕微鏡技術(1)~高感度EDX搭載TEMによるパワーデバイス用ゲート酸化膜/SiC界面のN分析~
New Techniques Using the Transmission Electron Microscope
高感度・高速EDX 搭載FE-TEM 装置
デバイスをはじめとする高機能材料の研究開発においては、ナノレベルで微量な元素を制御することが重要となっています。
当社で新規導入した分析FE-TEM(FEI社製TalosF200X型⇒図1)は、分析試料の極近傍に直交配置した4個のシリコンドリフト検出器(SDD)とその大きな立体角(0.9sr)の採用によって、従来の5倍以上のX線収集効率で、高速で高感度な元素分析を実現します。さらにWindowless検出器の採用により軽元素の検出にも有利で、ビーム損傷を抑えた高精細EDXマッピングや、従来のEDXでは検出できなかった0.1%以下の微量元素分析が可能になります。
ゲート酸化膜/SiC 界面のN分析
有望なSiC-MOSFET(Metal Oxide Semiconductor Field Effect Transistor)パワーデバイスの電気特性の向上のため、ゲート酸化膜の形成条件の適正化は重要です。図2は酸化(SiO2膜形成)後にNO雰囲気で窒化したSiO2/SiC界面のHAADF(High Angle Annular Dark Field: 高角環状暗視野)-STEM像です。HAADF像に示した四角の範囲における構成元素(C, N, O, Si)のEDX面分析結果を図3に示します。微量なNが界面に沿って一様に分布していることがわかります。
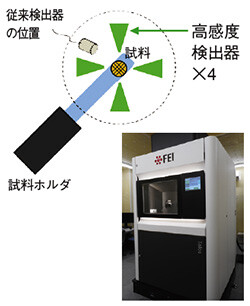
とFE-TEM装置概観(下)
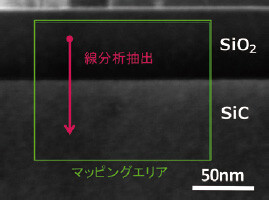
また、面分析結果より抽出した積算ラインプロファイル(図4)から、界面の厚さ数nmの領域に明瞭にNが濃化していることが分かりました。これらは従来のSTEM-EDXでは得ることが困難でした。この結果から、電気特性(チャンネル移動度など)を担っている界面の窒素濃化層を直接観察することが可能となったことで、特性向上のメカニズム解明および界面制御の研究開発が加速することが期待されます。
これからも微量元素のナノレベル分析にチャレンジします。ぜひお問い合わせください。
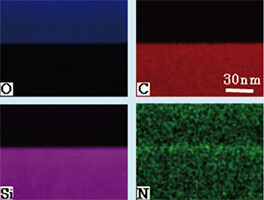
図3 SiO2/SiC界面のEDX面分析
試料ご提供:筑波大学 矢野祐司准教授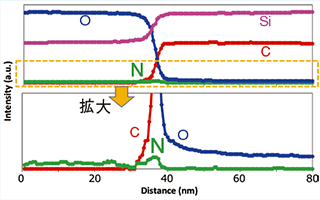
図4 SiO2/SiC界面のEDX線分析プロファイル
関連リンク・関連記事
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


