JFE-TEC News
No.14「電子材料(1)」
JFE-TEC News No.14号 極低加速SEM-EBSPを用いた結晶相解析 他 記事一覧

全文 PDF (663.2 KB)
No.14 極低加速SEM-EBSPを用いた結晶相解析 他
電子材料(1)~電子部品の故障解析・信頼性試験~
携帯用電子機器の普及とともに、電子部品の短小化や高密度化技術の進歩に著しいものがあります。当社でも電子部品や実装基板の故障解析や信頼性試験の依頼が増加しています。
故障解析
故障解析では、市場や、出荷/受入れ試験、信頼性試験、開発評価など様々な段階で発生した不良品の解析を行っています。そのため、故障現象、使用環境、動作期間などの事前情報を得ることが大切となります。その情報をもとに、非破壊調査により不具合箇所を絞り込みます。その後SEM、TEMなどを用いた物理分析や、化学、有機分析を行って故障原因を推測します。
非破壊調査
非破壊調査として簡単な電気特性測定、透過X線観察、超音波探傷を行っています。透過X線観察では、IC内部のボンディングワイヤーやプリント基板配線パターンなどの金属材料の状態を観察することにより、断線・接触などの不具合を調査します。超音波探傷では、材料間界面の剥離や、材料内部のクラックなどを調査します。電子部品は、環境の影響を避けるために樹脂や金属で封止されています。そのため、このような非破壊調査は非常に有効な手段となります。
破壊調査
破壊調査としては、故障箇所の観察、解析がし易くなるように、機械的、化学的な方法によるパッケージ開封、断面試料作製などを実施します。パッケージ開封では、封止樹脂や金属を除去して内部の素子を露出させます。断面試料作製では、パッケージ内部の数十μm程度のワイヤーやバンプの断面を正確に位置出しする技術を当社は保有しています。
写真1、2はICのオープン品を解析した事例です。透過X線観察、開封後観察では異常は観られなかったので、ワイヤーのリードフレーム側接続部(写真1の赤□部)を断面観察した結果、ワイヤーの断線が確認されました。
次回は信頼性試験について紹介します。
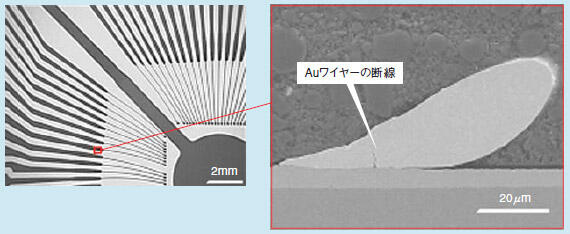
写真1 透過X線写真(左)と 写真2 断面SEM写真(資料作製:断面研磨)(右)
関連リンク・関連記事
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


