電子部品、電子デバイスの解析・調査
はんだの実装部不具合事例・信頼性試験
ページ内メニュー
カーケンダルボイド発生による、はんだ接合界面劣化 [実装部の不具合事例]
カーケンダルボイド*が多量に発生したことによる接合界面の劣化事例です。実装時の過剰の熱影響、使用環境の熱影響など により、金属間化合物層が成長し、それに伴い、カーケンダルボイドが多量に発生することがあります。
- * カーケンダルボイド発生のメカニズム
- 一般にカーケンダルボイドは、相互拡散の不均衡により発生した原子空孔(格子欠陥)が消滅することなく集積したことにより発生します。Sn/Cuの界面の場合、Cuの拡散に対してSnの拡散が少ないため、金属間化合物とCu界面に空孔が集積すると考えられています。
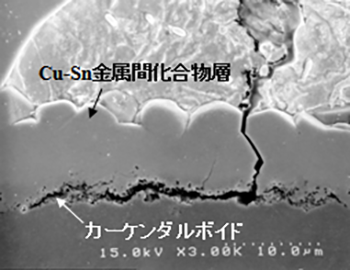
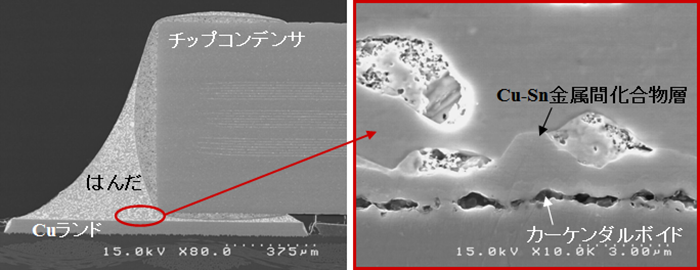
はんだ濡れ不具合 [実装部の不具合事例]
電子部品の電極やプリント基板ランドのめっき不具合により、はんだ濡れ不具合が発生します。
7 以下に示したのは、プリント基板のSnめっき不具合起因による事例です。
はんだ濡れ不具合部は、最表面にCu-Sn金属間化合物が存在していました。Sn/Cu界面には金属間化合物が生成していますが、金属間化合物は融点が高く不活性であり、最表面に生成される酸化層は、RMA系フラックスに溶解され難いため、はんだ濡れ性が劣化します。この領域は、ランドのSnめっきが薄く、Cu-Sn金属間化合物が表面に露出していたと推測されます。
電子部品電極のめっき状態を評価するため、はんだ濡れ性試験を調査することもあります。

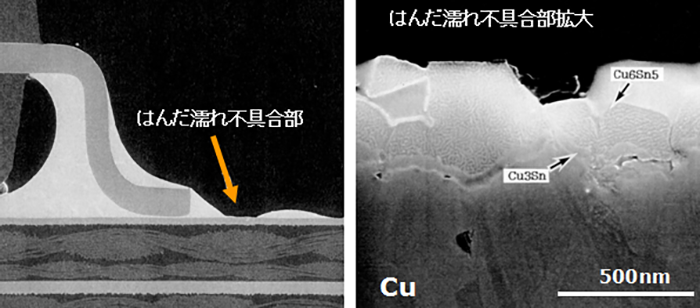
関連リンク:はんだ濡れ性試験
はんだ接合部評価(温度サイクル試験)[信頼性試験]
プリント基板実装品のはんだ接合部を評価する方法として、温度サイクル試験が一般的に用いられています。温度サイクル試験により、はんだ接合部に熱応力(各材料の熱膨張の差による)を負荷させ、強度変化及びクラック発生状態を調査します。
また、必要に応じて、欠陥部の調査として元素分析なども実施します。

-
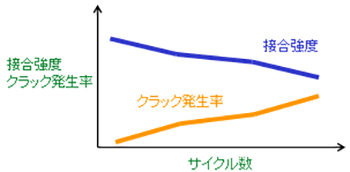
はんだ接合部の強度変化及びクラック発生率 -

QFP端子引張り試験 -
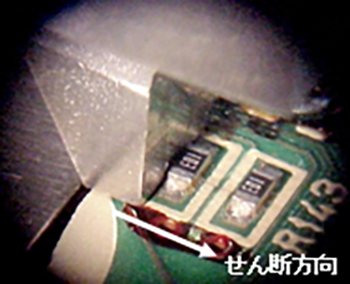
チップ部品せん断試験
-
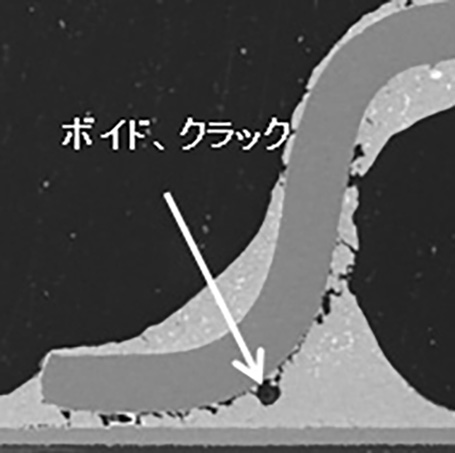
はんだ接合部の断面観察 -

ボイド発生部のEPMA元素マッピング
(融点100℃以下のSn-Bi-Pb3元共晶合金が生成したことによりボイドが発生)
イオンマイグレーション試験・調査
電位差のある狭ピッチの端子間では、水分、不純物イオンの影響によりイオンマイグレーションを発生することがあります。
- 試験の概要
基板に電圧を印加した状態で、高温高湿試験を実施し、イオンマイレーションが発生するのかを試験します。
試験中は、電圧をモニターし、電圧の変化から抵抗の変化を確認します(絶縁劣化の確認)。 - 試験後の調査
(1)光学顕微鏡観察、SEM観察
イオンマイグレーションが発生した箇所では、短絡の痕跡(デンドライト:樹状結晶など)が確認されます。
(2)元素分析(EDX分析、EPMA分析)、イオンクロマト分析
イオンマイグレーションが発生した箇所では、腐食促進成分となる塩素などが存在している場合があります。
(3)原因調査
基板の破壊調査(断面調査など)を実施して、腐食成分の由来(基板の配線パターン作製時に使用するエッチング液の残渣など)について調査します。

はんだ濡れ性試験 [信頼性試験]
電子部品電極などのはんだ濡れ性試験は、JIS Z 3198-4「鉛フリーはんだ試験方法-第4部:ウェッティングバランス法及び接触核法による濡れ性試験方法」に規定されています。以下にウェッティングバランス法について紹介します。
なお、評価方法は、試料形状などに影響されるため、同形状の製品(正常品など)との相対比較となります。
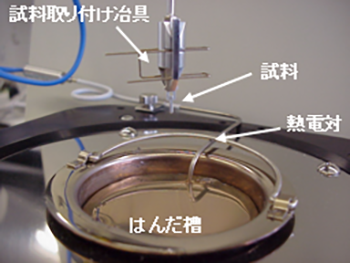
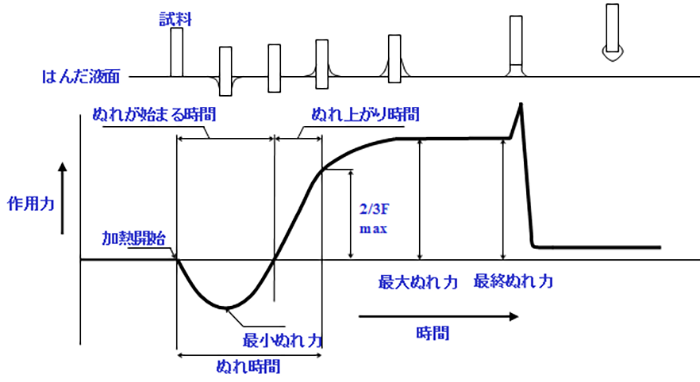
関連リンク:メニスコグラフ法による半田(はんだ)ぬれ試験
実装基板のはんだ耐久試験(曲げ試験)[信頼性試験]
BGA、CSPは、実装基板へのストレスが多い携帯機器など使用されています。BGA、CSPなどのはんだ接合部耐久性試験の一つとして、実装基板の曲げ試験による評価方法(EIAJ ED-4702 耐基板曲げ試験方法など)があります。はんだ接合部の抵抗をモニターし、破断までのサイクル数を調査します。
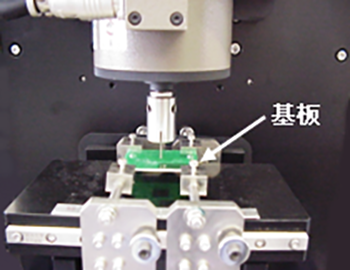
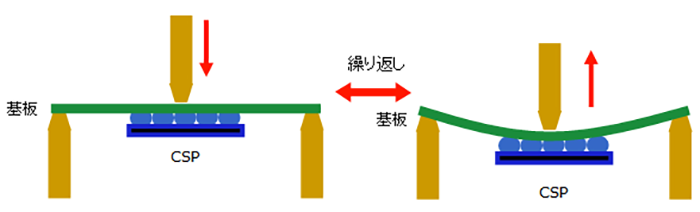

作業の流れ

関連リンク・関連記事
JFE-TEC Newsバックナンバー
- No.52(2017年7月)カーエレクトロニクス分野における分析・解析技術 ~電子機器におけるはんだ接合部の分析・解析~
- No.36(2013年7月)電気・電子部品の 腐食亀裂試験 ~ UL認証取得のための腐食試験~
- No.29(2011年10月)ガス腐食試験 ~低濃度ガス腐食試験による電子部品の信頼性評価~
- No.15(2008年4月)電子材料(2)~電子部品の故障解析・信頼性試験(2)~
- No.14(2008年1月)電子材料(1)~電子部品の故障解析・信頼性試験~
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


