物理分析
ULV-SEMを用いたCr(35nm/W(12nm))多層薄膜の分析
分析事例
10nmレベルの微細構造をULV-SEM(極低加速電圧走査電子顕微鏡)で観察でき、世界最高水準の分析技術で従来レベルをはるかに超える25nmのEDX分析が可能になりました。
ULV-SEMの反射電子(BSE)像により、酸化Ta薄膜上のCr(35nm)/W(12nm)の金属多層膜の形態が観察できるともに、従来の条件(加速電圧:10kV)では分離できなかった12nmのW層を、2.7kVと低加速電圧にすることで分析できます。
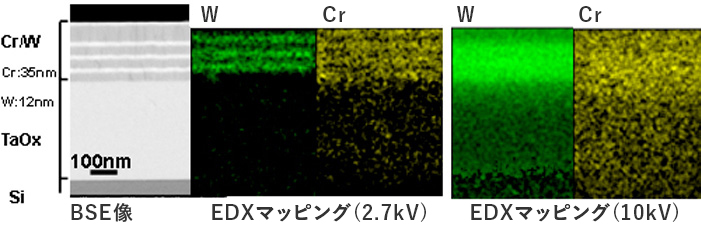
作業の流れ

関連ページ・関連リンク
このページに関する
お問い合わせはこちらから
- JFEテクノリサーチ株式会社 営業総括部
- 0120-643-777


